-

-
TESCAN AMBER X 氙離子源雙束聚焦掃描電子顯微鏡FIB-SEM

- 品牌:捷克泰思肯
- 型號: AMBER X
- 產地:歐洲 捷克
- 供應商報價:¥8000000
-
上海愛儀通網絡科技有限公司
 更新時間:2025-04-18 09:17:11
更新時間:2025-04-18 09:17:11 -
銷售范圍售全國
入駐年限第4年
營業執照已審核
- 同類產品FIB 聚焦離子束顯微鏡(10件)

立即掃碼咨詢
聯系方式:18701866315
聯系我們時請說明在儀器網(www.ghhbs.com.cn)上看到的!
掃 碼 分 享 -
為您推薦
產品特點
- iFIB+ 氙等離子FIB鏡筒
Z大離子束流可達1 μA, 可實現超高刻蝕速率
分辨率 : < 15 nm
無與倫比的超大視野:1 mm @ 30 keV
快速精確的壓電驅動光闌變換器
BrightBeam? 超高分辨SEM鏡筒技術
無漏磁超高分辨SEM鏡筒可以Z大程度實現各類樣品的分析和表征
分辨率:1.5 nm @ 1kV
優化的鏡筒內探測器系統,進一步提高了探測能力
光闌優化提升了分辨率,特別是在高束流下分辨率
Z新的 Essence? 電鏡軟件和用戶界面
用戶界面友好
可定制化的布局 詳細介紹
TESCAN AMBER X
等離子FIB和無漏磁超高分辨場發射掃描電鏡的完美結合,無限擴展在材料表征領域的應用
TESCAN AMBER X 是結合了分析型等離子FIB和超高分辨(UHR)掃描電鏡的綜合分析平臺,能夠同時提供高效率、大面積樣品刻蝕,多模態的樣品表征,以及在無鎵注入干擾狀態下進行樣品制備和改性。 TESCAN AMBER X 具備快速精確的等離子體FIB刻蝕和無漏磁超高分辨SEM成像的特性,使其成為多項研究的方案,例如快速制備出寬度可達1 毫米的截面; 高通量、多模態的FIB-SEM斷層掃描,可快速獲得三維重建圖像和可視化數據; 元素化學和/或晶體取向研究; 無注入離子干擾狀態下制備出微米和納米結構,以便通過其它分析方法進行后續測試或表征等。
主要特性
iFIB+ 氙等離子FIB鏡筒
最大離子束流可達1 μA, 可實現超高刻蝕速率
分辨率 : < 15 nm
無與倫比的超大視野:1 mm @ 30 keV
快速精確的壓電驅動光闌變換器
BrightBeam? 超高分辨SEM鏡筒技術
無漏磁超高分辨SEM鏡筒可以最大程度實現各類樣品的分析和表征
分辨率:1.5 nm @ 1kV
優化的鏡筒內探測器系統,進一步提高了探測能力
光闌優化提升了分辨率,特別是在高束流下分辨率
最新的 Essence? 電鏡軟件和用戶界面
用戶界面友好
可定制化的布局
主要應用
刻蝕和拋光大橫截面
在3.5小時內完成寬度達1 mm橫截面的刻蝕, 然后使用TESCAN專有的搖擺樣品臺,以較小的離子束流拋光橫截面,這樣可以抑制”幕簾效應“(curtaining),同時還可以在刻蝕過程中原位監控橫截面質量。FIB-SEM斷層掃描
AMBER X 是多尺度、多模態微結構表征的最佳選擇。這款等離子FIB支持快速地刻蝕和拋光樣品。TESCAN用于靜態3D EBSD數據采集的技術和嵌入式FIB-SEM層析成像模塊,可以支持各種成像和分析探測器,增加了實用性,使斷層掃描技術可以快速、精確且便捷地應用于各類材料的分析。無鎵干擾狀態下的樣品制備
傳統鎵離子 FIB加工時由于鎵離子污染或注入可能導致的微觀結構和/或機械性能改變。氙是一種惰性元素,所以可以實現對鋁等材料進行無污染的樣品制備和加工。


您可能感興趣的產品
-
 TESCAN AMBER X 氙離子源雙束聚焦掃描電子顯微鏡FIB-SEM
TESCAN AMBER X 氙離子源雙束聚焦掃描電子顯微鏡FIB-SEM
-
 TESCAN SOLARIS X 氙等離子源雙束聚焦掃描電子顯微鏡FIB-SEM
TESCAN SOLARIS X 氙等離子源雙束聚焦掃描電子顯微鏡FIB-SEM
-
 TESCAN AMBER 雙束聚焦掃描電子顯微鏡 FIB-SEM
TESCAN AMBER 雙束聚焦掃描電子顯微鏡 FIB-SEM
-
 TESCAN AMBER X 高分辨氙離子源雙束聚焦掃描電鏡(FIB-SEM)
TESCAN AMBER X 高分辨氙離子源雙束聚焦掃描電鏡(FIB-SEM)
-
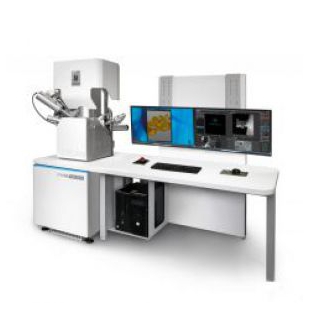 TESCAN SOLARIS 雙束聚焦掃描電子顯微鏡FIB-SEM
TESCAN SOLARIS 雙束聚焦掃描電子顯微鏡FIB-SEM
-
 TESCAN SOLARIS 超高分辨氙離子源雙束聚焦掃描電鏡(FIB-SEM)
TESCAN SOLARIS 超高分辨氙離子源雙束聚焦掃描電鏡(FIB-SEM)
-
 TESCAN AMBER 高分辨率雙束聚焦掃描電鏡系統(FIB-SEM)
TESCAN AMBER 高分辨率雙束聚焦掃描電鏡系統(FIB-SEM)
-
 捷克泰思肯 TESCAN AMBER X 高分辨氙離子源雙束掃描電鏡
捷克泰思肯 TESCAN AMBER X 高分辨氙離子源雙束掃描電鏡
-
 TESCAN SOLARIS 超高分辨雙束聚焦掃描電鏡(FIB-SEM)
TESCAN SOLARIS 超高分辨雙束聚焦掃描電鏡(FIB-SEM)
-
 TESCAN FIB-SEM-TOF-SIMS 雙束聚焦掃描電子顯微鏡-飛行時間二次離子質譜聯用系統
TESCAN FIB-SEM-TOF-SIMS 雙束聚焦掃描電子顯微鏡-飛行時間二次離子質譜聯用系統
-
 捷克泰思肯 TESCAN SOLARIS X 氙等離子源雙束FIB系統
捷克泰思肯 TESCAN SOLARIS X 氙等離子源雙束FIB系統
-
 賽默飛 Scios 2 DualBeam 雙束掃描電子顯微鏡FIB-SEM
賽默飛 Scios 2 DualBeam 雙束掃描電子顯微鏡FIB-SEM