-

-
TESCAN SOLARIS X 氙等離子源雙束聚焦掃描電子顯微鏡FIB-SEM

- 品牌:捷克泰思肯
- 型號: SOLARIS X
- 產地:歐洲 捷克
- 供應商報價:¥10000000
-
上海愛儀通網絡科技有限公司
 更新時間:2025-04-18 09:17:11
更新時間:2025-04-18 09:17:11 -
銷售范圍售全國
入駐年限第4年
營業執照已審核
- 同類產品FIB 聚焦離子束顯微鏡(10件)

立即掃碼咨詢
聯系方式:18701866315
聯系我們時請說明在儀器網(www.ghhbs.com.cn)上看到的!
掃 碼 分 享 -
為您推薦
詳細介紹
TESCAN SOLARIS X 是一款氙(Xe)等離子超高分辨雙束 FIB-SEM 系統,配置新穎的 TriglavTM 超高分辨率電子鏡筒以及最新款的 iFIB+TM 離子鏡筒,它的超高分辨表征能力和無與倫比的樣品制備效率,非常適合于材料、生命及半導體領域分析表征中最具挑戰性的大體積三維樣品的分析工作。
TESCAN SOLARIS X 配置的 TriglavTM 超高分辨率電子鏡筒,同時使用了全新的 TriLensTM 三透鏡系統以及高效的 TriSETM 和 TriBETM 探測器系統,能夠提供卓越的表面靈敏度和襯度圖像,實現對電子束高敏材料或不導電材料納米特征的觀察。
TESCAN SOLARIS X 是半導體和材料表征中最具挑戰性的物理失效分析應用的平臺,具有極高的精度和極高的效率。 它不但提供了納米尺寸結構分析所必需的高分辨率和表面靈敏度,為大體積 3D 樣品特性分析保證最佳條件。同時,它還提供非凡的 FIB 功能,可實現精確、無損的超大面積加工,包括封裝技術和光電器件的橫截面加工。
TESCAN SOLARIS X Xe Plasma FIB-SEM 主要優勢:1. 新的 Essence 軟件的用戶界面可實現更輕松、更快速、更流暢的操作,包括碰撞模型和可定制的面向應用流程的布局;2. 新一代 Triglav? UHR SEM 鏡筒具有極佳的分辨率,優化的鏡筒內探測器系統在低束流能量下具有卓越的性能;3. 軸向探測器通過能量過濾器,可以接收不同能量的電子信號,增強表面敏感性;4. 新型 iFIB+? Xe 等離子 FIB 鏡筒具有無與倫比的視野,可實現極大面積的截面加工;5. 新一代 SEM 鏡筒內探測器結合高濺射率 FIB,實現超快三維微分析;6. 氣體增強腐蝕和加工工藝,尤為適合封裝和 IC 去層應用;7. 高精度壓電驅動光闌,可實現 FIB 預設值之間的快速切換;8. 新一代 FIB 鏡筒具有 30 個光闌,可延長使用壽命,并最大限度地減少維護成本;9. 半自動離子束斑優化向導,可輕松選擇 FIB 銑削條件;10. 專用的面向工作流程的 SW 模塊、向導和工藝,可實現最大的吞吐量和易用性。突出特點
* 極高的吞吐量,適用于挑戰性的大體積銑削任務新型 iFIB+? Xe 等離子 FIB 鏡筒可提供高達 2 μA 的超高離子束束流,并保持束斑質量,從而縮短銑削任務的總時間。
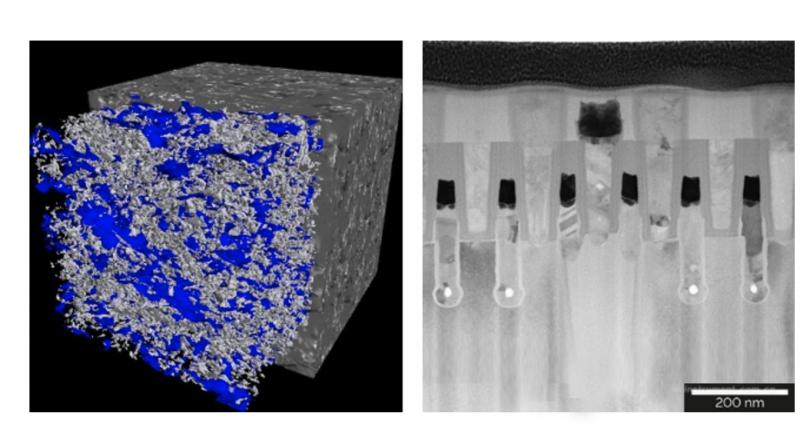
圖(左):SiAlON - 石墨烯樣品的三維重構圖像,使用 In-Beam f-BSE 探測器逐層成像,該樣品的 FIB-SEM 層析成像由 1339 層組成,重構的尺寸為 22×22.3×66.9 μm。
圖(右):使用 Xe 等離子體 FIB 從 DRAM 65 nm節點上制備出的 80 nm 厚度的 TEM 樣品,STEM-BF 高倍圖像。
* 新型 iFIB+? Xe 等離子 FIB 鏡筒具有無與倫比的視野,可實現極大面積的截面加工
新型 iFIB 鏡筒具有等離子 FIB-SEM 市場中最大的視場(FoV)。在30 keV 下最大視場范圍超過 1 mm,結合高離子束流帶來的超高濺射速率,可在幾個小時之內完成截面寬度達 1 mm 的電子封裝技術和其他大體積(如 MEMS 和顯示器)樣品加工。這是簡化復雜物理失效分析工作流程的最佳解決方案。
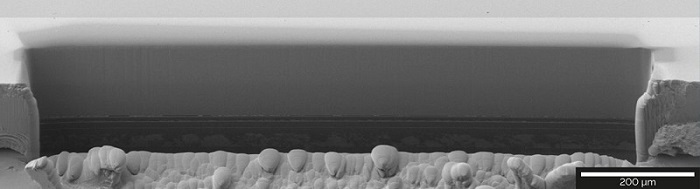
圖:OLED 顯示屏,橫截面長度為 1086 μm,視野范圍 1.26 mm
* 應用范圍廣闊,可擴展您在 FIB 分析和微加工應用范圍新型 iFIB+? Xe 等離子 FIB 離子束流強度可調范圍大,可在一臺機器中實現廣泛的應用:大電流可實現快速銑削速率,適用于大體積樣品去層;中等電流適用于大體積 FIB 斷層掃描;低束流用于 TEM 薄片拋光;超低束流用于無損拋光和納米加工。
* 充分利用電子和離子束功能,實現應用最大化快速、高效、高性能的氣體注入系統(GIS)對于所有 FIB 應用都是必不可少的。新的 OptiGIS? 具有所有這些品質,TESCAN SOLARIS X 可以配備多達 6 個 OptiGIS 單元,或者可選配一個在線多噴嘴 5-GIS 系統。此外,不同的專有氣體化學品和經過驗證的配方可用于封裝技術的物理失效分析。
* 輕松實現 FIB 精確調節,并保證 FIB 最佳性能新型 iFIB+ 鏡筒配有超穩定的高壓電源和精確的壓電驅動光闌,可在 FIB 預設值之間快速切換。此外,半自動束斑優化向導允許用戶輕松選擇最佳束斑,以優化特定應用的 FIB 銑削條件。
* 最小的表面損傷和無 Ga 離子注入樣品制備,以保持樣品的特性與 Ga 離子相比,Xe 離子的離子注入范圍和相互作用體積明顯更小,因此帶來的非晶化損傷也更小,這在制備 TEM 樣品薄片時尤其重要。此外,Xe 離子的惰性特性可防止研磨樣品的原子形成金屬化合物,這可能導致樣品物理性質的變化,從而干擾電測量或其它分析。
* 強大的檢測系統由 TriSE? 和 TriBE? 組成的多探測器系統,可收集不同角度的 SE 和 BSE 信號,以獲得樣品的最大信息。
* 改進和擴展成像功能,獲得有意義的襯度新一代 Triglav? 鏡筒內探測器系統經過優化,信號檢測效率提高了三倍。此外,增加的能量過濾功能,可以對軸向 BSE 信號過濾采集。通過選擇性地收集低能量軸向 BSE,實現用不同的襯度來增強表面靈敏度。
* 超高速三維微分析鏡筒內探測器系統可實現快速圖像采集,結合 Xe 等離子體 FIB 的高濺射速率,可實現 3D 微量分析的超快速數據采集。EDS 和 EBSD 數據可以在 FIB-SEM 斷層掃描期間同時獲得。使用專用軟件進行后處理,可以獲得 3D 重建,實現整個焊球、TSV、金屬合金等樣品的獨特微觀結構,成分和晶體學信息。
* 提供微分析的最佳工作條件新一代 Triglav? 還具有自適應束斑優化功能,可提高大束流下的分辨率。這有利于快速實現 EDS,WDS 和 EBSD 等分析技術。
* 更低的TOF-SIMS分析檢測限,可獲得不受干擾的元素質譜數據(與Ga+ FIB 相反,Ga+ 峰可能干擾其他元素如 Ce, Ge 和 Ga 本身的檢測)。* 不犧牲空間分辨率,而實現快速微分析Triglav? SEM 鏡筒結合新型肖特基 FE 槍,可實現高達 400 nA 的電子束流,并實現束流快速調整。In-Flight Beam Tracing? 功能可以實現束流和束斑優化,滿足微區分析的最佳條件。
* 大尺寸晶圓分析得益于最佳的 60° 物鏡的幾何設計和大樣品腔室,可實現對 6“ 和 8”晶圓任意位置的 SEM 和 FIB 分析。
* 輕松實現以往復雜操作新的 TESCAN Essence? 軟件平臺是一個優秀的多用戶界面軟件,可以快速方便地訪問主要功能。用戶界面易于學習,并可實現用戶定制,以適應特定的應用程序和用戶的技能水平以及使用習慣。各種軟件模塊,向導和流程使所有 FIB-SEM 應用程序都能為新手和專家用戶提供輕松,流暢的體驗,從而提高生產力并有助于提高實驗室的效率。新的 TESCAN Essence? 還提供先進的 DrawBeam? 矢量掃描發生器,用于快速精確的 FIB 加工和電子束光刻。

* TESCAN SOLARIS X 是 S9000X 的升級機型。
您可能感興趣的產品
-
 TESCAN SOLARIS X 氙等離子源雙束聚焦掃描電子顯微鏡FIB-SEM
TESCAN SOLARIS X 氙等離子源雙束聚焦掃描電子顯微鏡FIB-SEM
-
 TESCAN AMBER X 氙離子源雙束聚焦掃描電子顯微鏡FIB-SEM
TESCAN AMBER X 氙離子源雙束聚焦掃描電子顯微鏡FIB-SEM
-
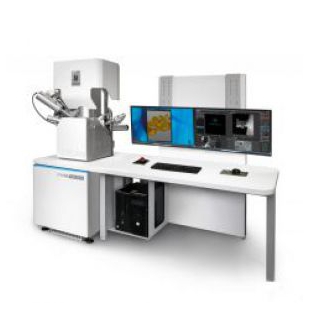 TESCAN SOLARIS 雙束聚焦掃描電子顯微鏡FIB-SEM
TESCAN SOLARIS 雙束聚焦掃描電子顯微鏡FIB-SEM
-
 TESCAN SOLARIS 超高分辨氙離子源雙束聚焦掃描電鏡(FIB-SEM)
TESCAN SOLARIS 超高分辨氙離子源雙束聚焦掃描電鏡(FIB-SEM)
-
 TESCAN AMBER 雙束聚焦掃描電子顯微鏡 FIB-SEM
TESCAN AMBER 雙束聚焦掃描電子顯微鏡 FIB-SEM
-
 TESCAN AMBER X 高分辨氙離子源雙束聚焦掃描電鏡(FIB-SEM)
TESCAN AMBER X 高分辨氙離子源雙束聚焦掃描電鏡(FIB-SEM)
-
 TESCAN SOLARIS 超高分辨雙束聚焦掃描電鏡(FIB-SEM)
TESCAN SOLARIS 超高分辨雙束聚焦掃描電鏡(FIB-SEM)
-
 捷克泰思肯 TESCAN SOLARIS X 氙等離子源雙束FIB系統
捷克泰思肯 TESCAN SOLARIS X 氙等離子源雙束FIB系統
-
 TESCAN AMBER 高分辨率雙束聚焦掃描電鏡系統(FIB-SEM)
TESCAN AMBER 高分辨率雙束聚焦掃描電鏡系統(FIB-SEM)
-
 TESCAN FIB-SEM-TOF-SIMS 雙束聚焦掃描電子顯微鏡-飛行時間二次離子質譜聯用系統
TESCAN FIB-SEM-TOF-SIMS 雙束聚焦掃描電子顯微鏡-飛行時間二次離子質譜聯用系統
-
 捷克泰思肯 TESCAN AMBER X 高分辨氙離子源雙束掃描電鏡
捷克泰思肯 TESCAN AMBER X 高分辨氙離子源雙束掃描電鏡
-
 賽默飛 Scios 2 DualBeam 雙束掃描電子顯微鏡FIB-SEM
賽默飛 Scios 2 DualBeam 雙束掃描電子顯微鏡FIB-SEM














