-

-
德國 ALLRESIST 紫外光刻膠
- 品牌:德國Allresist
- 型號: AR-P 3200,AR-U 4000,AR-N4340
- 產地:歐洲 德國
- 供應商報價:面議
-
深圳市藍星宇電子科技有限公司
 更新時間:2025-04-21 10:17:21
更新時間:2025-04-21 10:17:21 -
銷售范圍售全國
入駐年限第7年
營業執照已審核
- 同類產品光刻膠(12件)

立即掃碼咨詢
聯系方式:13538131258
聯系我們時請說明在儀器網(www.ghhbs.com.cn)上看到的!
掃 碼 分 享 -
為您推薦
- 1
- 2
- 3
產品特點
- 德國 ALLRESIST 紫外光刻膠,各種工藝:噴涂專用膠,化學放大膠,lift-off膠,圖形反轉膠,高分辨率膠,LIGA用膠等。各種波長: 深紫外(Deep UV)、I線(i-line)、G線(g-line)、長波(longwave)曝光用光刻膠。各種厚度: 光刻膠厚度可從幾十納米到上百微米。
詳細介紹
德國 ALLRESIST 紫外光刻膠
1. 紫外光刻膠(Photoresist)
1)各種工藝:噴涂專用膠,化學放大膠,lift-off膠,圖形反轉膠,高分辨率膠,LIGA用膠等。
2)各種波長: 深紫外(Deep UV)、I線(i-line)、G線(g-line)、長波(longwave)曝光用光刻膠。
3)各種厚度: 光刻膠厚度可從幾十納米到上百微米。
電子束光刻膠(電子束抗蝕劑)(E-beam resist)
1)電子束正膠:PMMA膠,PMMA/MA聚合物, LIGA用膠等。
2)電子束負膠:高分辨率電子束負膠,化學放大膠(高靈敏度電子束膠)等。
特殊工藝用光刻膠(Special manufacture/experimental sample)
電子束曝光導電膠,耐酸堿保護膠,聚酰亞胺膠(耐高溫保護膠),全息光刻用膠,長波曝光膠,深紫外曝光膠等特殊工藝用膠。
4.配套試劑(Process chemicals)
顯影液、除膠劑、稀釋劑、增附劑(粘附劑)、定影液等。
一.紫外光刻膠(Photoresist)
1. 正膠:
AR-P 1200 噴涂用光刻膠(Spray Coating)
適合噴涂(Spray Coating)的正性光刻膠,高靈敏度。膠層表面非常平整,且可很好的保護粗糙的襯底表面,可用于復雜工藝。

AR-P 3100 薄膠
高靈敏度光刻膠,膠膜薄且均勻。在玻璃和鍍鉻表面附著力好,可用于光學器件加工、掩膜制作、激光干涉曝光等。另有,AR-P 3170 可以做出 100nm,甚至更小的線條(幾十納米)。

AR-P 3200 厚膠
黏度大,可得到厚膠膜,厚度可達幾十微米,甚至上百微米。膠膜覆蓋能力好,適合粗糙的 Wafer 表面涂膠,可很好的保護結構邊緣。圖形剖面邊緣陡直。適合做LIGA或電鍍工藝等。
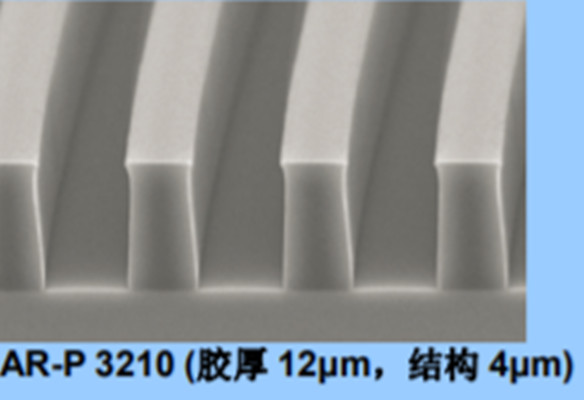
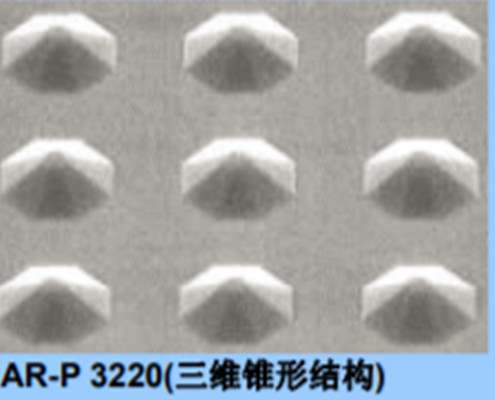
AR-P 3500,AR-P 3500T 通用型光刻膠
適于集成電路制造中的掩膜加工。高敏感、高分辨率且在金屬和氧化物表面附著力好。其中,AR-P 3500T是針對 AR-P 3500 系列進行優化,而新研制的一種光刻膠;性能和AR-P 3500相似,同時還具備了良好的耐等離子刻蝕性能,以及大的工藝寬容度。
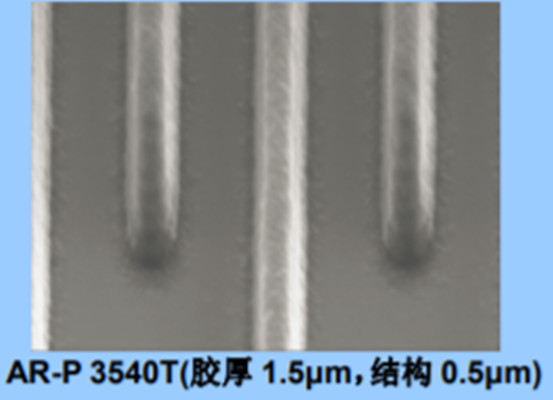
AR-P 3700/3800 高分辨率光刻膠
可用于制作亞微米結構,如高集成電路等。甩膠層表面平整均勻,高敏感度,高對比,良好的結構穩定性,工藝要求范圍寬。AR-P 3840為染色的光刻膠,可以降低駐波和散射等的影響。

AR-P 5300 單層Lift-Off工藝用膠
Lift-off工藝用膠,利用普通的光刻工藝便可很容易得進行剝離工藝。高敏感、高分辨率,且與金屬和氧化物表面附著良好。
2. 圖形反轉膠
AR-U 4000 圖形反轉膠
通過調整工藝參數可實現正膠或負膠性能。圖形反轉工藝后,光刻膠呈現負膠性能,可以得到非常明星的倒梯形結果,用于lift-off工藝。

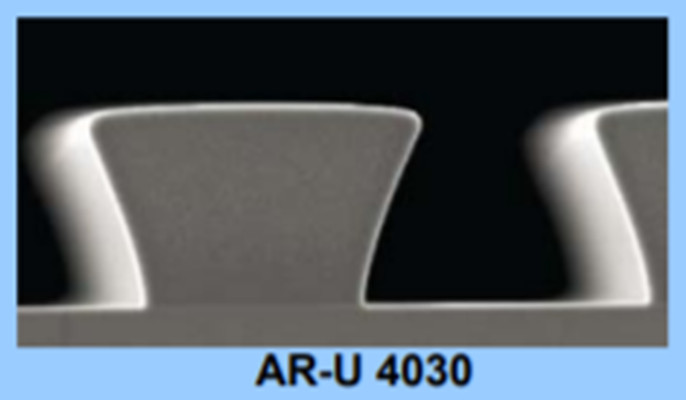
3.負膠
AR-N 2200
適合噴涂(Spray Coating)的負性光刻膠,高靈敏度。膠層表面非常平整,且可很好的保護粗糙的襯底表面,可用于復雜工藝。
AR-N 4240 紫外、深紫外曝光,可做lift-off工藝
i線、深紫外曝光。適合制作亞微米圖形,專為滿足先進集成電路制造中的關鍵工藝要求而設計。良好的耐等離子體刻蝕性能,在金屬和氧化物表面的附著力好,并可用于lift-off工藝。

AR-N 4340 化學放大膠,紫外曝光,可做lift-off工藝
i線、g線曝光。化學放大膠,高靈敏度,高分辨率,高對比度,在金屬和氧化物表面附著力好,可用于lift-off工藝。
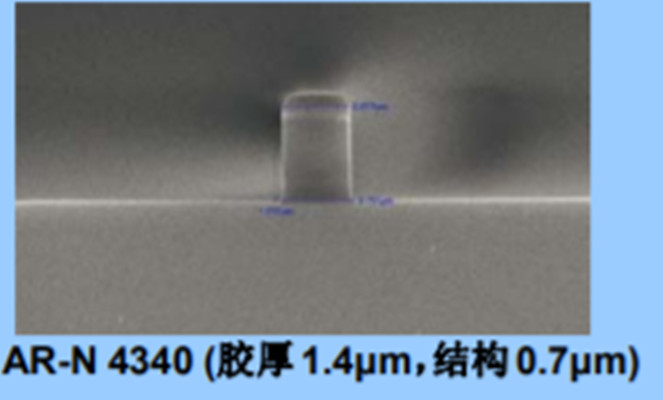
AR-N 4400 厚膠,化學放大膠,可以做lift-off工藝
i線、g線、深紫外、X-ray、電子束等都可以實現曝光。涂膠厚度從幾十微米到上百微米,覆蓋能力好,可用于表面粗糙的wafer表面涂覆,且剖面陡直,高分辨率。化學放大膠,靈敏度也非常高。可用于LIGA、電鍍等工藝。采用堿性水溶液顯影,除膠非常容易,可以提到傳統的SU8膠。

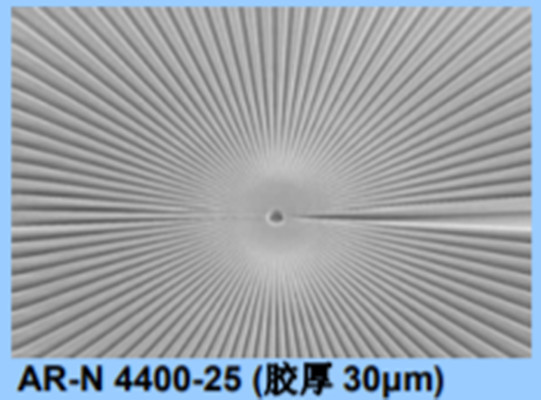
二.電子束抗蝕劑
1.正膠
PMMA(AR-P 631~ 671,AR-P 639~ 679,AR-P 672)
PMMA膠最主要的特點是高分辨率、高對比度、低靈敏度。
PMMA膠種類齊全,不同的系列中包含了各種分子量(50K, 200K, 600K, 950K),各種溶劑(氯苯,乳酸乙酯,苯甲醚)以及各種固含量的PMMA膠,以滿足各類電子束光刻的工藝要求。另外,廠商還可以根據客戶的具體需求來生產其他分子量、固含量的PMMA膠。
PMMA膠可用于單層或雙層電子束曝光、轉移碳納米管或石墨烯、絕緣層等多種工藝。
(注:工廠可根據用戶的需求,定制所需分子量、固含量的PMMA膠。)
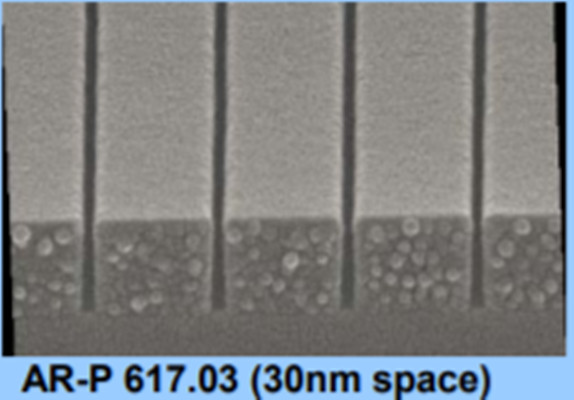
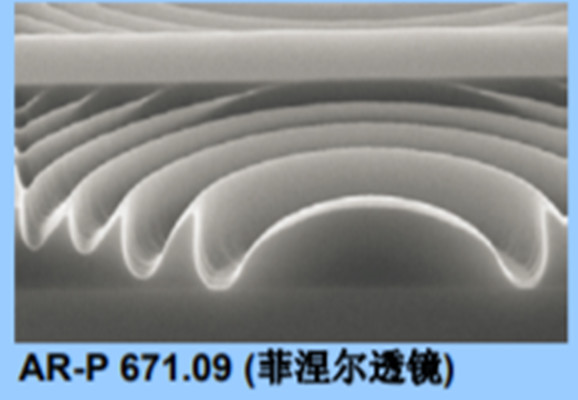
AR-P 617 (PMMA/MA共聚物)
適合目前各種應用需要的電子束光刻膠。靈敏度高,是普通PMMA膠的3~ 4倍,對比度亦高于PMMA。 PMMA/MA共聚物也可以和PMMA通過雙層工藝實現lift-off工藝。
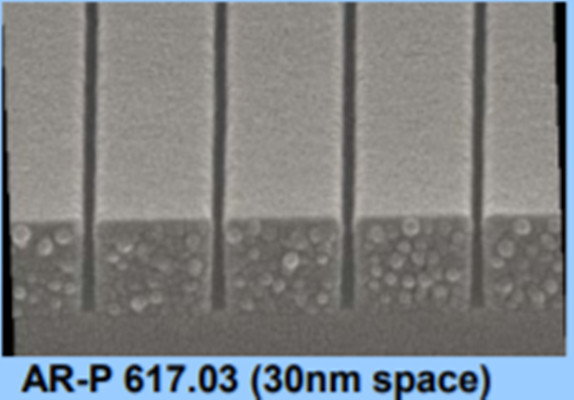
AR-P 6200 超高分辨率、高耐刻蝕電子束正膠
高分辨率,通過簡單的工藝即可得到10nm甚至更小的結構。高深寬比(可達20:1),高對比度(>15)。良好的耐干法刻蝕性能,是PMMA膠的2倍。完全可以取代ZEP膠,經濟實惠,并且采購簡單,包裝規格多樣化。
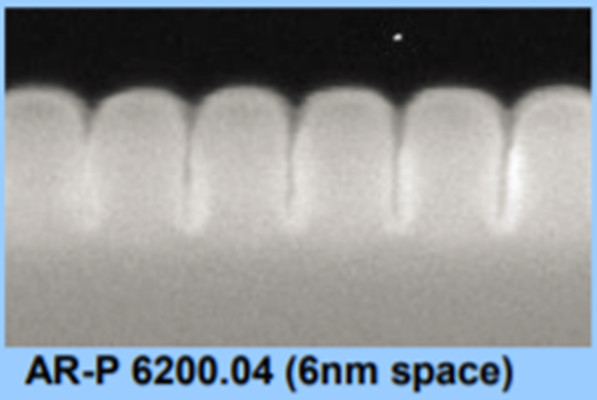
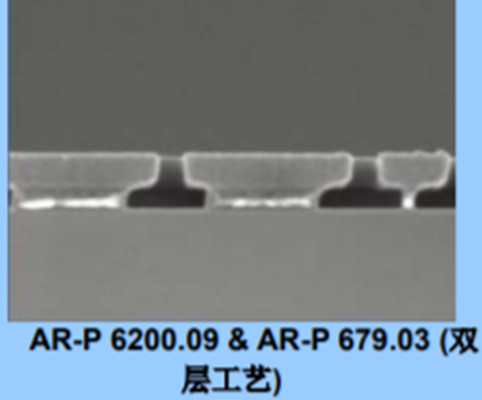
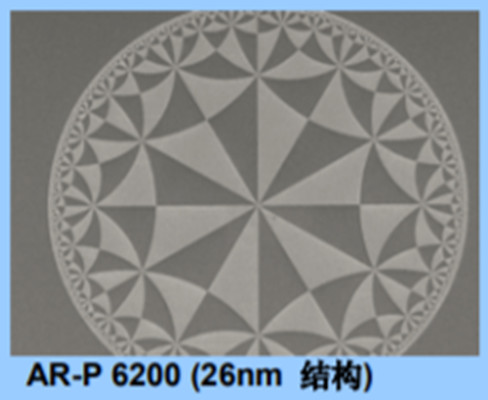
AR-P 6510 (PMMA厚膠)LIGA工藝用正膠
以PMMA為基礎開發出的電子束厚膠,厚度從10~250μm不等,圖形剖面陡直。主要用于LIGA工藝和X-Ray 曝光工藝。

2.負膠
AR-N 7500, AR-N 7520 電子束負膠,高分辨率
分辨率高(30nm),對比度高(> 5),良好的耐等離子刻蝕性能,可以用于混合曝光。靈敏度中等,介于AR-N 7700和PMMA之間。
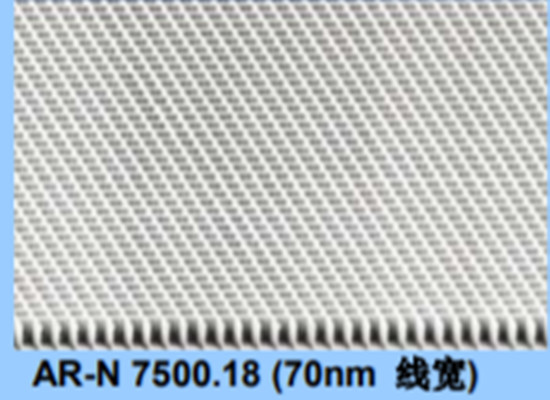

AR-N 7700 電子束負膠,化學放大膠,高靈敏度
化學放大負膠,高靈敏度,高對比度,良好的耐等離子刻蝕刻蝕性能,可以用于混合曝光。
AR-N 7720 電子束負膠,三維曝光
化學放大負膠,高靈敏度,對比度非常小(<1),非常適合制作三維結構;也可以用于衍射光學及全息器件的加工。

X AR-N 7700/30,SX AR-N 7700/37 電子束負膠,化學放大膠,超高靈敏度
化學放大負膠,超高高分辨率,良好的耐等離子刻蝕能力,適合混合曝光。高靈敏度,靈敏度比AR-N 7700更高。
三 .特殊用途的光刻膠
AR-PC 5090.02 /5091.02電子束曝光用導電膠,不含光敏物質。
在絕緣襯底上做電子束曝光時,為了避免電荷累積,大家通常會選擇涂一層導電膠,來消除電荷累積。在正常的曝光結束后,導電膠會溶于水中,非常容易去除,不會影響正常的電子束曝光工藝。
AR-BR 5400 雙層Lift-Off工藝底層膠
可以得到穩定的Lift-off結構,利于金屬的沉積。在制作雙層工藝時,需要和正膠AR-P 3500或AR-P 3500T配合使用。從270nm到紅外區,有良好的光學透明性,熱穩定性好。
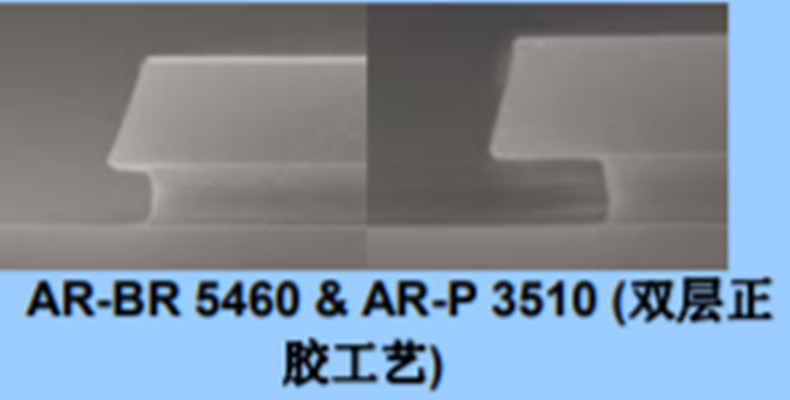
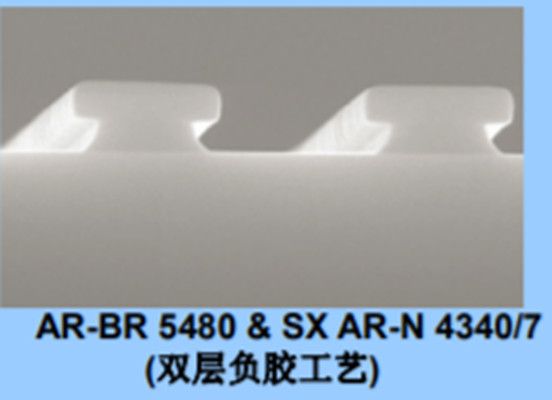
AR-PC 500 耐酸堿保護膠
在酸堿中有很好的耐刻蝕性能,不含光敏物質。尤其在堿性環境(40% KOH)中非常穩定。一般涂于襯底背面,防止刻蝕工藝中的化學物質損害其背面結構。503顏色為黑色,較504耐刻蝕性能稍弱。

SX AR-PC 5000/40 耐酸堿保護膠
在酸堿中有很好的耐刻蝕性能,不含光敏物質。在40%的KOH和50%的HF中,具有很好的保護作用的,耐刻蝕時間可以長達數小時。另外,還可以和正膠配合使用,通過雙層工藝來制作圖形。

AR-P 5910 耐HF酸刻蝕光刻膠,正膠
對基底有很好的粘附性,一般用于低濃度的HF,在5% 以下的HF 酸中有很好的保護作用。
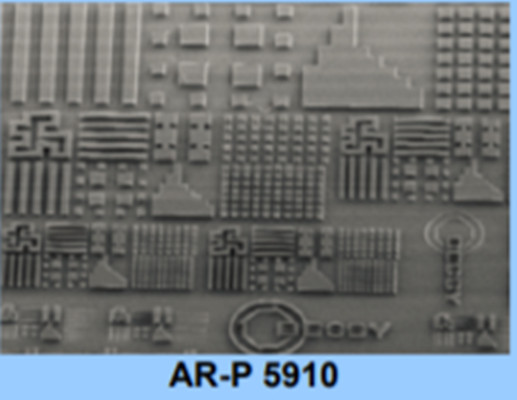
X AR-P 5900/4 耐堿刻蝕光刻膠,正膠
主要用于耐堿刻蝕以及保護層。光刻膠可以在2n(2mol/L)的NaOH中可以穩定很長時間。
SX AR-PC 5000/80 聚酰亞胺光刻膠,不含光敏物質
熱穩定性光刻膠,在400°C時仍然很穩定。不含光敏物質,但是可以和正膠配合使用,通過雙層工藝來制作圖形。可以用于制作傳感器材料、保護層及絕緣層。
SX AR-PC 5000/82 聚酰亞胺光刻膠,紫外正膠
熱穩定性光刻膠,正膠,在400°C時仍然很穩定。具有良好的耐等離子刻蝕性能,可用于離子注入工藝。
X AR-P 5800/7 深紫外曝光膠,正膠
深紫外曝光(248 - 265 nm 和300 - 450 nm),在這個波長范圍內,光刻膠的透射率高。耐刻蝕性能好。適合接觸曝光,曝光過程中,產生的氮氣少,可以提高圖形質量。
SX AR-P 3500/6 全息曝光用膠,正膠
在長波段具有很好的靈敏度,敏感波段為(308 – 500nm),主要用于全息曝光工藝。
SX AR-N 4800/16 有機溶劑顯影光刻膠(用于無水環境),負膠
基于PMMA的負膠,曝光波長230 – 365nm。主要用于工藝中襯底材料對水敏感,需要無水環境操作的情況。采用有機溶劑顯影,避免了水或潮氣對襯底材料的破壞。
四.配套試劑
顯影液
多種配套顯影液,可用于紫外光刻膠,電子束光刻膠、特殊用途用等光刻膠的顯影。
定影液
主要用于電子束光刻膠用定影液。
除膠劑
多種配套除膠劑,可用于紫外光刻膠,電子束光刻膠、特殊用途用等光刻膠的除膠。
稀釋劑
多種配套稀釋劑,可用于紫外光刻膠,電子束光刻膠、特殊用途用等光刻膠的稀釋。
增附劑
除了傳統的HMDS可作為增附劑外,我們還可以提供AR 300-80型增附劑,AR 300-80使用更簡單,毒性更小。
您可能感興趣的產品
-
 德國 ALLRESIST 紫外光刻膠
德國 ALLRESIST 紫外光刻膠
-
 德國 ALLRESIST 紫外光刻膠
德國 ALLRESIST 紫外光刻膠
-
 Allresist 紫外光刻膠 AR-N 4400
Allresist 紫外光刻膠 AR-N 4400
-
 德國Allresist 特殊工藝用光刻膠
德國Allresist 特殊工藝用光刻膠
-
 Allresist 紫外光刻膠 AR-N 4600 (Atlas 46)
Allresist 紫外光刻膠 AR-N 4600 (Atlas 46)
-
 Allresist 光刻膠 AR系列
Allresist 光刻膠 AR系列
-
 Allresist 特殊功能光刻膠 SX AR-PC 5000/41
Allresist 特殊功能光刻膠 SX AR-PC 5000/41
-
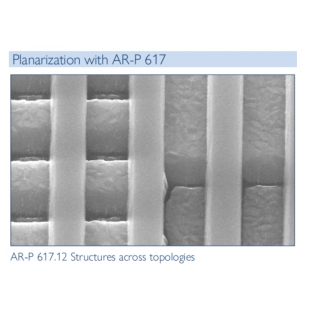 德國Allresist AR-P617 電子束光刻膠
德國Allresist AR-P617 電子束光刻膠
-
 德國Allresist 正電子束光刻膠
德國Allresist 正電子束光刻膠
-
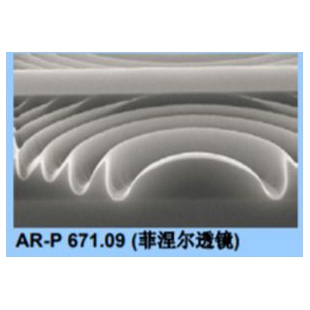 德國Allresist 電子束光刻膠AR-P 617
德國Allresist 電子束光刻膠AR-P 617
-
 德國ALLRESIST導電膠AR-PC5090 和 AR-PC5091
德國ALLRESIST導電膠AR-PC5090 和 AR-PC5091
-
 德國Allresist 正電子束光刻膠 AR-P 6200
德國Allresist 正電子束光刻膠 AR-P 6200